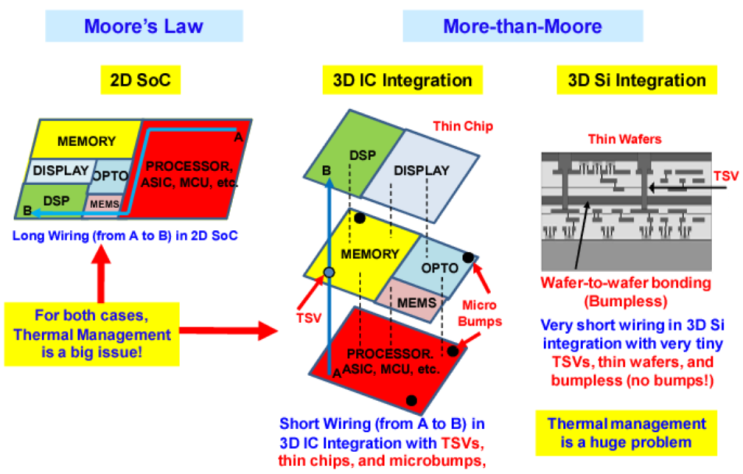
소프트웨어 산업은 나날이 "단위시간 당 더 높은 데이터 처리량"을 요구합니다. 반도체 성능은 이것을 제대로 따라오지 못하고 있습니다. 무어의 법칙으로 대표되는 반도체 산업의 끊임없는 미세화 행진은 최근 몇 년 동안 상당한 어려움에 직면해 있습니다. 여기서 더 미세화를 하더라도, 기존의 2D 스케일링 접근 방식은 근본적인 물리적, 경제적 한계에 부딪히고 있습니다. 누설 전류, 전력 손실, 제조 복잡성은 더 이상 2D 스케일링으로 관리하기가 점점 더 어려워지고 있습니다. 이러한 상황에서 3D 집적 회로(3D-IC)는 같은 미세 공정 수준을 유지하더라도, 더 높은 성능을 만들 수 있는 대안이 되고 있습니다. 그리고 칩도 작게 나눠서 설계하여 양산 경제성도 극복 할 수 있구요. 2D에서 3D 반도체까지의 서사 설계적으로는 최대한 작업을 병렬적으로 처리 할 수 있도록, 하드웨어를 병렬적으로 설계 -> Chip area가 커짐. 평면적으로 커지는데, Physical layout에서 다양한 문제...
원문링크 : 3D IC란? Advanced packaging이란? Interposer란? 3DIC란? 2D IC와 비교 시점에서.




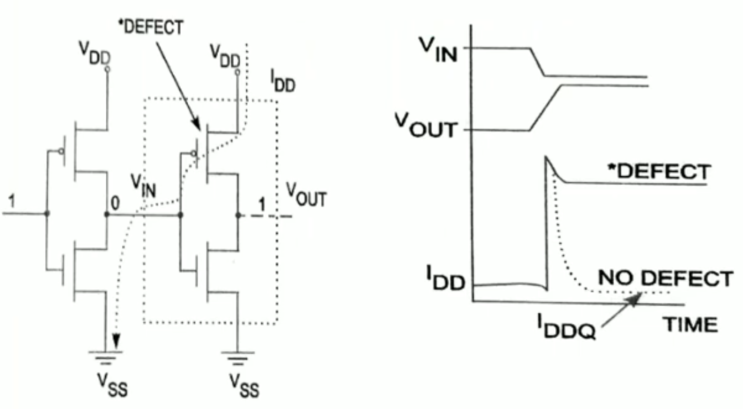

 네이버 블로그
네이버 블로그 티스토리
티스토리 커뮤니티
커뮤니티