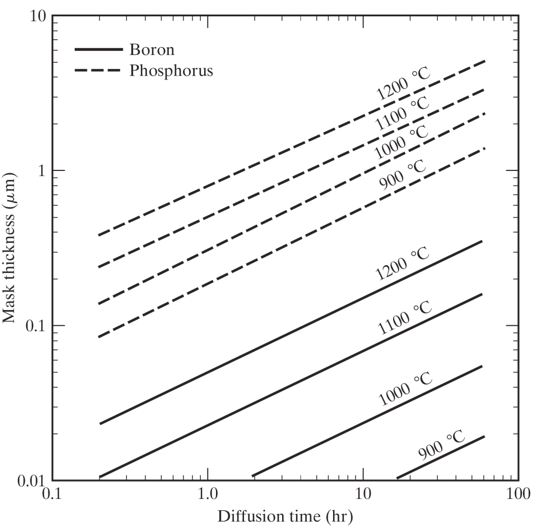
1. Masking Property 앞서 다양한 조건이 산화막 내부의 O2나 H2O의 움직임을 통제한다고 설명했습니다. 마찬가지로 Doping을 할 때도 여러가지 통제 조건이 있습니다. Si에 Doping을 할 때, SiO2를 증착하고, 그 위에 Dophant source를 올려서 열처리를 진행합니다. 이때, 확산이 일어나는데 등방성(Isotropic)을 갖고 Si와 SiO2에 동시에 확산이 진행됩니다. 원하지 않는 부분에 Doping이 되는 것을 막기 위해 확산 속도에 비례하게 Masking의 두께를 설정해야 합니다. Introduction to Microelectronic Fabrication, 2nd Ed., R. C. Jaeger 위 그림에서 Phosphorus와 Boron 처럼 물질의 종류에 따라 확산 속도가 다르기 때문에 Mask의 두께를 다르게 해야 합니다. 또한, 높은 온도에서 더 빠르게 확산이 일어나기 때문에 Mask의 두께를 더 두껍게 만들어줘야 합니다. 2. Ox...
#8대공정
#Oxide
#마스킹
#반도체
#반도체공정
#산화공정
#산화막
#확산공정
원문링크 : 반도체 공정 23.5장(Masking property & Oxide quality)
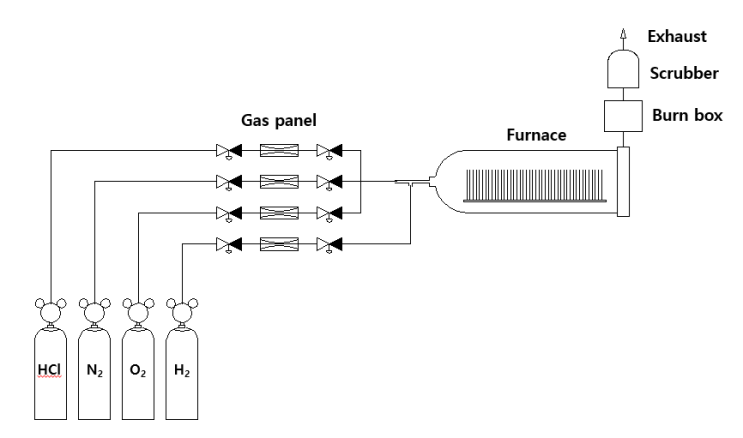

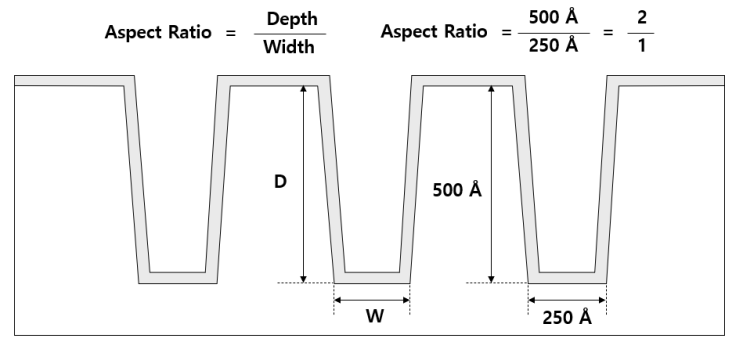
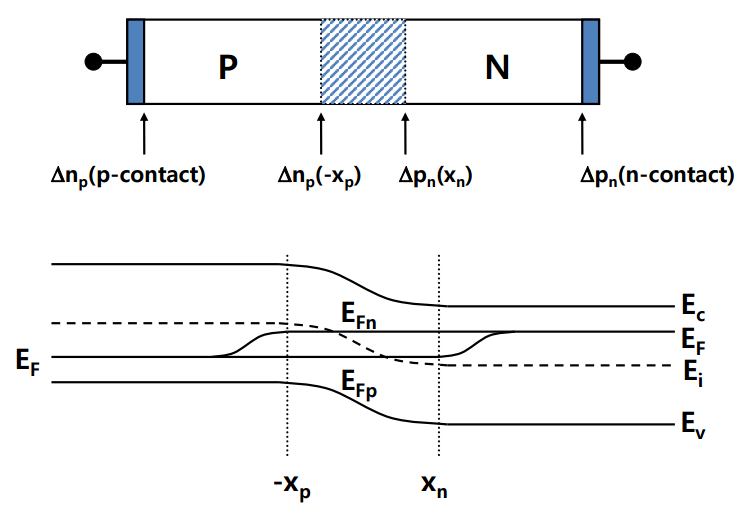



 네이버 블로그
네이버 블로그 티스토리
티스토리 커뮤니티
커뮤니티