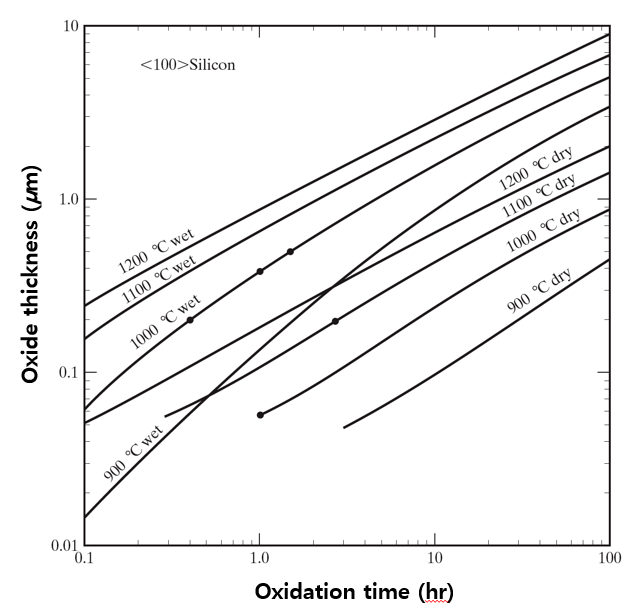
저번 시간까지 Thermal oxidation을 수식으로 표현한 모델인 Deal and Grove model에 대해 알아봤습니다. 이번 시간에는 산화막 생성의 다양한 변수와 측정값에 대해 알아보겠습니다. 1. Wafer orientation(100 vs 111) Introduction to Microelectronic Fabrication, 2nd Ed., R. C. Jaeger 앞서 반응 초기에는 산화막이 얇기 떄문에 웨이퍼 계면의 Si 반응 속도가 bottle neck process라고 설명했습니다. Si-Si bond를 끊는데 필요한 에너지는 일정하기 때문에, 면의 밀도가 높을 수록 산소와 더 많이 맞닿을 수 있어 산화막 성장 속도가 빠릅니다. Si 웨이퍼에서 <100> 면보다 <111> 면에서 실리콘 원자의 밀도가 높습니다. 따라서 위 그래프에서 <111> 웨이퍼에서 초기 산화막 성장 속도가 빠르고, 시간이 지날 수록 diffusion이 bottle neck process가 ...
#8대공정
#반도체
#반도체공정
#반도체산화
#산화막
#확산공정
원문링크 : 반도체 공정 23장(Thermal oxidation의 다양한 변수)


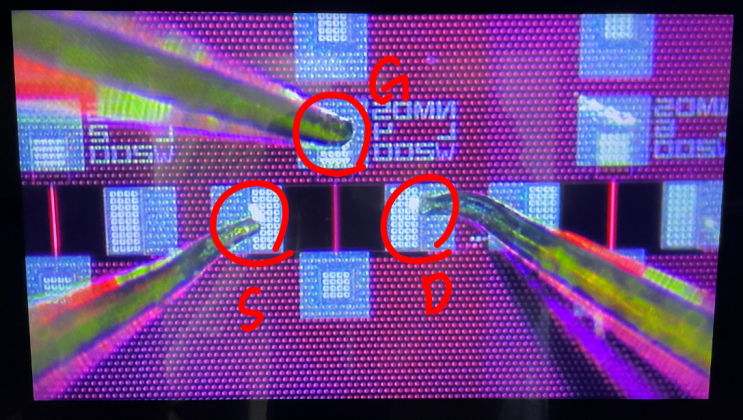
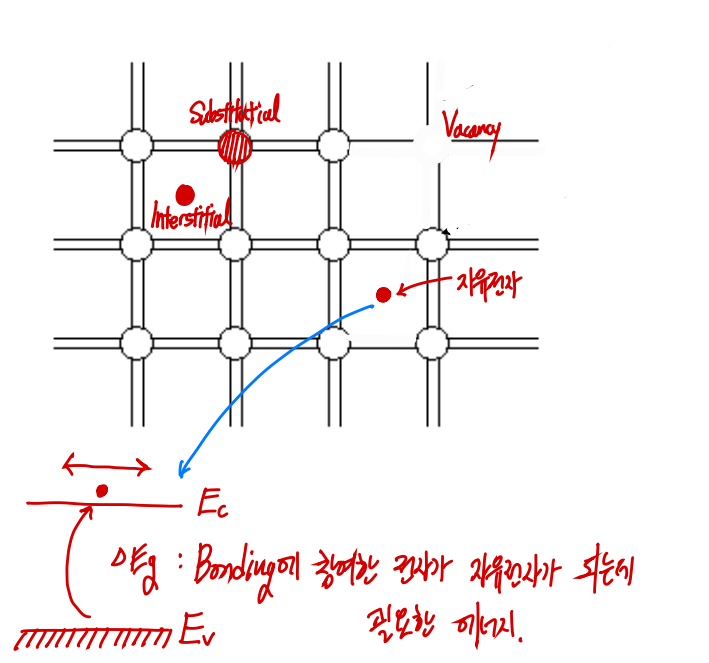

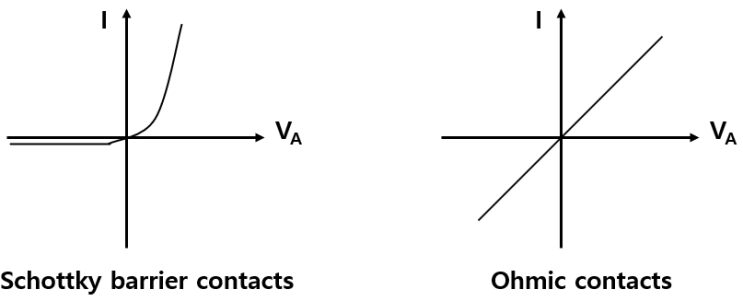

 네이버 블로그
네이버 블로그 티스토리
티스토리 커뮤니티
커뮤니티